
用IGBT构成的高频整流器和用晶闸管一样是对输入电压波形实行切割,所不同的是,晶闸管是对输入电压波形实现集中切割,需要多少切割多少;而且BT是对输入电压波形实行均匀地高频切割,如图2.18所示。有的是频率固定而切割宽度可调,有的是宽度固定而频率可调,这样做的目的是为了使输入电流和电压同相,达到输入功率因数为l的目的。既然如此,就和用晶闸管时不一样了,是不是 就可以将输人电压的变化范围变得很大呢? 事情也并非如此简单。为了说明这个问题, 不得不从IGBT的性质说起,而且IGBT将是图2. 18用IGBT作高频整流器的切割波形情况今后UPS中的主导器件。

2) IGBT的性能
IGBT称做绝缘门极双极晶体管(Insulated Gate Bipolar Transistor),它是综合了功率场效应管MOSFET和达林顿晶体管GTR二者的优点的一种器件。由表2.1可以看出它们之间的关系。
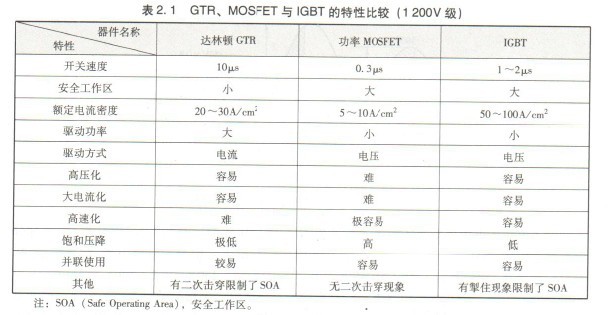
从表中可以看出, IGBT的性能处于功率场效应管MOSFET和达林顿晶体管GTR之间,并且集中了二者的优点。比如, GTR是电流驱动,因此驱动效率低、驱动电路复杂,而MOSFET是电压驱动,因此驱动效率特别高,驱动电路也简单,于是, IGBT就采用了电压 驱动方式;器件打开后, MOSFET的饱和压降大,造成功耗大、效率低,而GTR的饱和压降非常低,因此其功耗小、效率高,故IGBT就采用了它的这个优点,等等。所以IGBT一问世就得到了广泛的使用。据东芝公司以前的报导, 1200V/100A等级IGBT的导通电阻是同一耐压规格功率MOSFET的1110;开关时间是同规格GTR的1110。一般GTR的工作频率在5kHz以下, MOSFET在30kHz以上, IGBT的工作频率在10 ~ 30kHz之间。
3) IGBT的简单工作原理
上述那些优点是如何实现的呢?这个问题可以用图2.19 (a)所示的简化等效电路来说明。IGBT相当于一个由MOSFET驱动的厚基区GTR,图中电阻Rd,是厚基区GTR基区内的调制电阻。它有三个极,分别称做漏极D (Drain)、游、极S (Source)和栅极G (Gate),有的也将栅极称为门极。由这个等效电路图也可以看出, IGBT是以GTR为主导的器件, MOS-FET只是一个驱动器件。图中的GTR是PNP管构成的达林顿管, MOSFET为N沟道器件。 因此这种结构称为N-IGBT,或称N沟道IGBT。
IGBT的图形符号有两种,如图2.19 (b)所示。图2. 19 (b)左面表示的是N-IGBT的 一种图形符号,它和MOSFET的图形符号基本相似,不同的是在漏极增加了一个向内的箭头,其含义就是注入孔穴。至于P-IGBT的图形符号也类似,只要把原来的箭头方向反转180。就可以了。图2. 19 (b)右面表示的是N-IGBT的另一种图形符号,在这里漏极和源极 的名称被集电极C (Collector)和发射极E (Emitter)所代替。
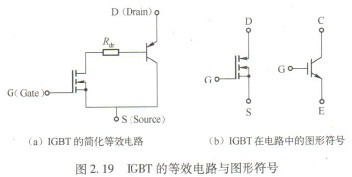
IGBT的开通与关断是由门极电压来控制的。门极加上正向电压时, MOSFET内形成沟 道,并为PNP晶体管提供基极电流通路,从而打开IGBT,使其进入导通状态。此时,从P(区)注入到N(区)的空穴(少数载流子)对N(区)进行电导调制,以减小N(区)的电阻Rd"使Rd,耐压的IGBT也具有通态电压特性。在门极上施加反向电压后, MOSFET的沟道消失, PNP晶体管的基极电流通道被切断,从而IGBT被关断。由此可见, IGBT的驱动原理与MOSFET基本相同。
[NT:PAGE=UPS的一般技术指标-输入整流器采用IGBT情况1$]
4) IGBT的掣住效应与安全工作区
(1) IGBT的掣住效应
IGBT在UPS中应用颇广,尤其在高频机中,整流器和逆变器己应用多时,成为UPS的 主导器件,因此不妨在这里多作一些介绍。虽然已被广泛应用于功率电子设备中,但和其他器件一样, IGBT也不是十全十美的,也有一定的局限性。掣住效应与安全工作区的限制就规定了它的使用范围和存在的问题。为了简单起见,曾用图2.19 (a)的等效电路来说明它的工作原理,但是IGBT更复杂的现象需用图2.20的等效电路来解释。从这个等效电路中可以看出, IGBT复合器件内有一个寄生晶闸管存在,它由PNP和NPN两个晶体管构成,这也正是晶闸管的等效电路。NPN晶体管的基极与发射极之间由于器件PN结结构的原因形成了一个井联的体区电阻Rbr,在该电阻上P型体区的横向空穴流会产生一个压降。对于13结来说,相当于加上了一个正向偏置电压,在规定的漏极电流范围内,这个正向偏压值并不大,对NPN晶体管不起作用。当漏极电流增大到一定程度时,该正向偏置电压就足以使NPN晶体管开通,由于NPN晶体管的开通为PNP晶体管的基极电流提供了通路,进而使这个管子也达到开启的程度, PNP晶体管的开通又为NPN提供了足够的基极电流,这样一个死循环雪崩式的正因馈过程使寄生晶闸管完全开通,这时即使在门极上施加负偏压也不能控制其关断,这就是所谓的掣住效应。IGBT出现掣住效应后,漏极电流因已不受控制而进一步增大,最后导致器件损坏。由此可知,漏极电流有一个临界值10M,大于此值的电流就会导致掣住效应。为此,器件制造厂必须规定漏极的电流最大值10M,以及与此相应的门源电压最大值。漏极通态电流的连续值超过10M时产生的掣住效应称为静态掣住现象。
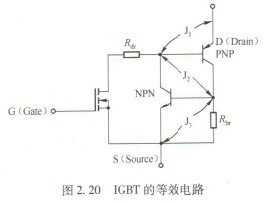
值得指出的是, lGBT在关断的动态过程中也会产生掣住效应。动态掣住效应所允许的漏极电流比静态时小,因此,制造厂家所规定的10M值一般是按动态掣住效应所允许的最大漏极电流确定的。lGBT关断时, MOSFET的关断十分迅速, lGBT的总电流也很快减小为零。与此相应, 12结上的反向电压也在迅速建立,此电压建立的快慢与lGBT所能承受的重加电压变化率也os/dt有关。duos/ dt越大, 12结上的反向电压就建立得越快;但同时duos/dt在12结上引起的位移电流el2 ( duos/ dt)越大。此位移电流为空穴电流,也称做出口s/dt电 流。当duos/dt电流流过体区扩展电阻Rb,时,就会产生足以使NPN晶体管开通的正向偏置电压,从而满足寄生晶闸管开通掣住的条件。由此可知,动态过程中掣住现象的产生主要由duos/出来决定。除此之外还有温度的影响,当温度过高时PNP和NPN晶体管的泄漏电流也 会使寄生晶闸管产生导通掣住的现象。
从上述的讨论可以看出,当采用lGBT进行高频整流时,也会出现与晶闸管同样的情况。因此,它的输人电压范围也不会比晶闸管宽,一旦掣住现象发生也将面临和晶闸管同样的命运,在设计时要充分考虑到这一点。
为了避免lGBT出现掣住现象,在设计电路时应保证lGBT中的电流不要超过10M;或者用加大门极电阻矶的办法延长lGBT的关断时间,或减小重加duos/dt值。
(2) lGBT的安全工作区SOA (Safe Operating Area)
任何元器件都存在一个安全工作区, lGBT也不例外,它在开通与关断时也有安全区。
在上例N型lGBT中,开通时为正向偏置,其安全区称为正向偏置安全工作区,简写为FB-SOA,如图2.21 (a)所示。FBSOA与其导通时间t密切相关,导通时间很短时FBSOA为矩 形区域,随着导通时间的加长,安全区的范围逐渐缩小,直流(DC)工作时的范围最小。这是因为导通时间越长,发热越严重。这种情况与MOSFET的情况相似。
IGBT关断时的门极电压为反向偏置,其安全区称为反向偏置安全工作区,简写为RB- SOA,如图2.21 (b)所示。RBSOA和FBSOA稍有不同, RBSOA随着IGBT关断时的重加 duos/dt而改变。电压巾。s/dt上升率越大,安全工作区越小,它与晶闸管和GTO等器件一样,过高的重加duos/dt会使IGBT导通,产生掣住效应。一般通过适当选择门源电压和门极驱动电阻即可减缓重加duos/dt的速率,以防止掣住效应的发生。
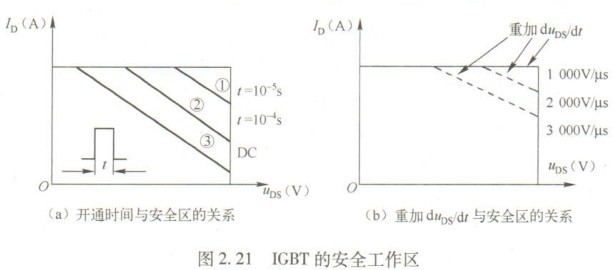
最大漏极电流10M是根据避免动态掣住效应而确定的,与此相应还确定了最大的门源电压VCSM,只要不超过这个值,外电路发生故障时, lGBT从饱和导通状态进人放大状态,漏极电流与漏游、电压元关,基本保持为恒定值,这种特性有利于通过控制门极电压使漏极电流不再增加,进而避免掣住效应的发生。在这种状态下应尽快关断lGBT,以避免因过度发热而导致器件损坏。比如当门源电压VCS = 10 ~ 15V时,漏极电流可在5 ~ 10µs内超过额定电流4 ~ 10倍,在这种情况下仍能用反向偏置的VCS进行关断。若超过这个界限, IGBT就有损坏的危险。
IGBT允许的最大漏源电压VOSM是由该器件中PNP晶体管的击穿电压确定的,目前已有耐 压1200V以上的器件。IGBT的最高允许结温一般商用器件为150"(:。功率MOSFET的通态压降随着结温的升高而显著增加,而且BT的通态压降VOS(on)则在室温和最高结温之间变化甚小,其原因是IGBT中MOSFET部分的压降为正温度系数,而PNP晶体管部分的压降是负温度系数,两者相结合使器件获得了良好的温度特性。现以东芝公司MG25N2S1型25A110∞V的IG-BT模块为例,说明它的具体特性和参数,便不了解这种器件的读者有一个定性和定量的印象。 表2.2给出了该模块的最大额定值;表2.3给出了其各种电气特性。在这里IGBT各电极的参数采用图2.19 (b)右图所示的符号,即漏极改为集电极,源极改为发射极。
在上述表中,源漏电压(即集电极-发射极电压) VCES可以是600V、1000V和1200V等,但其门极-发射极电压VCES是不可以超过的,同样结温和紧固力矩也是不可以超过的。
责任编辑:scarlett
更多内容请关注机房360,www.jifang360.com,中国绿色数据中心
[NT:PAGE=UPS的一般技术指标-输入整流器采用IGBT情况2$]